Perché hai bisogno dei nostri servizi, sai che stai ricevendo professionisti altamente qualificati che hanno la competenza e l'esperienza per assicurarti che il tuo progetto sia svolto correttamente e funzioni.

Diodi e transistor con canali AlN forniscono elevate tensioni di rottura e funzionamento a temperature incredibilmente elevate.
NUMEROSE attività umane si stanno espandendo in ambienti estremi, spesso motivate dallo sfruttamento delle risorse. Ciò ha portato l'esplorazione in varie direzioni, compreso il sottosuolo profondo, a grandi profondità nel mare e nello spazio profondo. In tutti questi ambienti la temperatura è estrema: supera i 300 °C sulla superficie di Venere, durante la perforazione di pozzi profondi e nello spazio all’interno di un motore in funzione.
Per saperne di più su tutti questi ambienti è necessario l’impiego di sensori. Ma quelli più ovvi, cioè quelli basati sul silicio, non sono all’altezza del compito, a causa di un limite di temperatura operativa relativamente basso. Ciò significa che per arricchire le nostre vite da questi ambienti, dobbiamo sviluppare elettronica per temperature estreme.
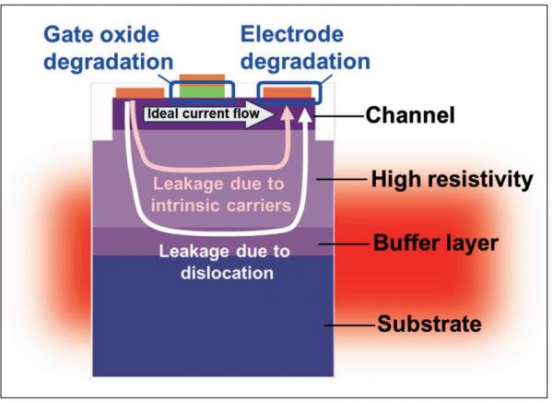
Figura 1. Il percorso della corrente di dispersione e i punti di degradazione termica in un MESFET con un ossido di gate.
Quando tutti i tipi di dispositivi a semiconduttore vengono utilizzati a temperature estreme, devono affrontare problemi associati a materiali, elettrodi, ossidi di gate e imballaggio (vedere Figura 1). All'aumentare della temperatura si generano numerose coppie elettrone-lacuna, dovute all'eccitazione degli elettroni dal massimo della banda di valenza al minimo della banda di conduzione. Questi elettroni, che aumentano la concentrazione dei portatori intrinseci (vedi Figura 2 (a)), sono dannosi, poiché aumentano la corrente di dispersione dei dispositivi e ne impediscono lo spegnimento. Le opzioni per ridurre la corrente di dispersione includono l'introduzione di materiali semiconduttori con un'energia di banda proibita maggiore e concentrazioni di portatori intrinseci inferiori (vedere Figura 2 (b)) o la limitazione della diffusione di corrente da aree diverse dal canale. Passare a uno strato di canale circondato da strati ad alta resistività che hanno basse concentrazioni di donatori/accettori effettivi e basse concentrazioni di difetti può aumentare la temperatura operativa del dispositivo. Un altro approccio consiste nel distribuire dispositivi con giunzioni pn, come JFET e BJT. In questi casi, è anche importante selezionare metalli refrattari per gli elettrodi che abbiano una reattività minima con i semiconduttori di base. In particolare, titanio, vanadio, tantalio, molibdeno, tungsteno e platino sono migliori a questo scopo di alluminio, magnesio, rame, argento, indio e oro.
Perché utilizzare AlN?
Esistono molti materiali semiconduttori con un'energia di bandgap maggiore rispetto al silicio. Includono SiC (3,3 eV), GaN (3,4 eV), Ga2O3 (4,7-5,2 eV), diamante (5,5 eV) e AlN (6,1 eV). Il team della NASA, guidato da Philip Neudeck, ha riferito che i JFET SiC possono funzionare a temperature superiori a 800 °C. Anche se questo è senza dubbio un risultato impressionante, i materiali con bande proibite ancora più ampie promettono di raggiungere temperature ancora più elevate. Tuttavia, molti di essi presentano notevoli inconvenienti. Il GaN soffre di un'elevata concentrazione di donatori efficaci pari a 1016 cm-3; non è possibile formare Ga di tipo p2O3 strati; e il diamante inizia a reagire con l'ossigeno a circa 700 °C. In netto contrasto, l'AlN non presenta difetti evidenti e offre stabilità termica e drogaggio controllabile. Grazie a queste caratteristiche, il nostro team dell’Università di Tsukuba ha dedicato tutta la nostra attenzione all’AlN per lo sviluppo di dispositivi a temperature estreme.
Storicamente si presume che l’AlN sia valido solo come isolante. Tuttavia, circa 20 anni fa, Yoshitaka Taniyasu e colleghi dell’NTT hanno dimostrato che questo non è il caso facendo crescere strati AlN elettricamente conduttivi mediante MOCVD.
Questa squadra ha registrato una mobilità elettronica di 426 cm2 V-1 s-1 per strati AlN drogati con silicio, per una concentrazione di drogante di 3 x 1017 cm-3. Basandosi su questo lavoro, sono diventati pionieri della crescita AlN di tipo p e hanno dimostrato i primi LED AlN con una lunghezza d'onda di 210 nm e diodi AlN p-n quasi verticali. A questi successi si deve il recente e rapido sviluppo dei LED UV profondi basati su AlGaN e AlN.
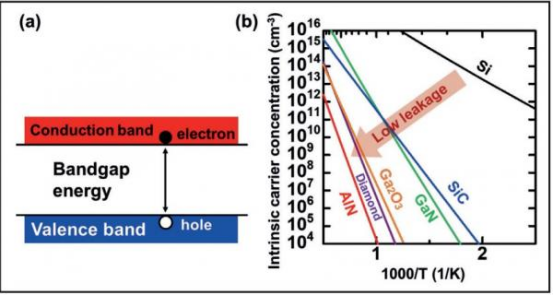
Figura 2. (a) Un'illustrazione della generazione di coppie elettrone-lacuna ad alte temperature. (b) La concentrazione intrinseca del portatore di silicio, SiC, GaN, diamante β-Ga2O3 e AlN in funzione della temperatura reciproca.
Oltre ai dispositivi ottici, la comunità di ricerca ha studiato i diodi a barriera Schottky AlN e gli HEMT AlN/AlGaN, per esplorare i potenziali vantaggi di un campo elettrico critico elevato. Sfortunatamente, questi dispositivi soffrono di una bassa concentrazione di portatori, a causa delle elevate energie di ionizzazione per i donatori e gli accettori: è di 0,3 eV per il silicio e 0,6 eV per il magnesio. Per questo motivo, le concentrazioni dei portatori per entrambi questi droganti sono circa due ordini di grandezza inferiori alle loro concentrazioni, facendo sì che i dispositivi abbiano correnti molto piccole. Per superare questo problema, il nostro team, in collaborazione con ricercatori del MIT e dell’Università di Aalto, ha aperto nuove strade introducendo il drogaggio indotto dalla polarizzazione nelle strutture AlGaN/AlN N-polari. Grazie alle polarizzazioni spontanee e piezoelettriche, questa forma di drogaggio può aumentare la corrente e ridurre la resistività dei contatti. Utilizzando il drogaggio indotto dalla polarizzazione, abbiamo dimostrato i primi PolFET e HEMT basati su AlN N-polari con correnti di drain superiori a 100 mA mm-1. Tale successo ci ha portato a considerare l'AlN come un pratico semiconduttore per dispositivi ottici ed elettrici.
Per produrre questi dispositivi, abbiamo potuto attingere a numerosi fornitori di materiali. Campioni di AlN di alta qualità su substrati di zaffiro da 2 pollici possono essere acquistati da Dowa Electronics Materials e AlN sfuso da 2 pollici è disponibile in commercio da Stanley e Asahi Kasei.

Figura 3. (a) Profili di profondità della concentrazione di impurità di silicio, ossigeno e carbonio in uno strato AlN impiantato in silicio spesso 3 µm dopo ricottura a 1600 °C. (b) Profili di profondità della concentrazione di magnesio in uno strato AlN impiantato con magnesio spesso 1 µm dopo la ricottura.
Doping AlN
Il controllo della concentrazione di droganti nei semiconduttori è l'incorporazione di impurità durante la crescita dei cristalli, nonché la diffusione termica e possibilmente l'impianto. Quest'ultima è una tecnologia interessante, che consente un controllo preciso della dose e garantisce un'elevata uniformità laterale del drogante. Tuttavia, quando vengono impiegati impianti ad alte dosi, questi tendono a danneggiare i reticoli cristallini e a introdurre alte concentrazioni di difetti puntiformi, che possono compensare i portatori. Fortunatamente, la maggior parte di questo danno può essere riparato con la ricottura post-termica, che abbiamo utilizzato durante la produzione di un canale AlN di tipo n impiantato in silicio.
Una delle caratteristiche impressionanti dei cristalli AlN, comprese le loro superfici, è la robustezza a temperature elevate, con stabilità sotto gas di azoto fino a 1700 °C. Questa robustezza fornisce un'ampia finestra per riparare i danni dell'impianto: questo processo richiede temperature superiori a 1200 °C per l'attivazione elettrica dello strato AlN impiantato in silicio. Si noti, tuttavia, che è necessaria molta attenzione quando si seleziona la temperatura di ricottura, poiché può determinare altri cambiamenti nel materiale. Oltre i 1400 °C le impurità di silicio e ossigeno si diffondono all'interno dello strato sovrastante. A causa della diffusione degli atomi di ossigeno dal substrato di zaffiro, che si decompone a 1500 °C sotto gas di azoto, un sottile strato di AlN su un substrato di zaffiro avrà un'elevata concentrazione di ossigeno dopo la ricottura ad alta temperatura, portando a caratteristiche elettriche degradate.
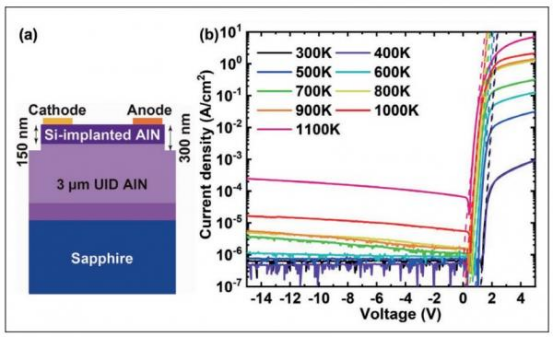
Figura 4. (a) La sezione trasversale di un diodo a barriera Schottky con un canale AlN impiantato in silicio. Anodo Ni/Au e catodo Ti/Al/Ti/Au. (b) Caratteristiche di densità-tensione di corrente di un diodo a barriera Schottky AlN da 27 °C a 827 °C.
Attraverso la collaborazione con MIT, Aalto University, TNSC e Dowa Electronics Materials, abbiamo studiato la diffusione degli atomi di silicio, ossigeno e magnesio nell'AlN (vedere Figura 3). Le nostre indagini hanno rivelato che gli atomi di ossigeno che diffondono da un substrato di zaffiro non possono raggiungere lo strato del canale dopo la ricottura utilizzando strati AlN spessi 3 µm. Ciò ci ha portato a concludere che gli intervalli di temperatura di ricottura preferiti per gli strati AlN elettricamente conduttivi con impianti di silicio e magnesio sono rispettivamente 1200-1600 °C e 1400-1500 °C. Questa conoscenza ci ha permesso di dimostrare i primi transistor a canale AlN.
Quando la fabbricazione di dispositivi prevede condizioni vicine all'equilibrio termico, come crescita epitassiale e ricottura ad alta temperatura, è favorita la formazione di stati profondi con energie di ionizzazione di 250-320 meV. Ciò tende a portare ad un’autocompensazione del donatore di silicio, una situazione in accordo con i nostri risultati.
Nel frattempo, l'uso di processi di non equilibrio, come l'impianto ionico, consente un aumento della popolazione di donatori superficiali con energie di ionizzazione di 64-86 meV. Ciò ha portato Hayden Breckenridge e colleghi dell’Università della Carolina del Nord e Adroit Materials a produrre uno strato altamente conduttivo di AlN mediante impianto di silicio e post-ricottura a una temperatura relativamente bassa di 1200 °C. Un altro risultato incoraggiante, proveniente dall’Università di Kyoto, è che l’energia di legame sostitutivo dell’accettore di magnesio di AlN è solo 250-410 meV, un valore molto inferiore all’energia di ionizzazione degli accettori di magnesio nei comuni strati di AlN coltivati con MOCVD. Presi insieme, questi risultati indicano che se le condizioni di processo di non equilibrio possono essere controllate in modo riproducibile e semplice in AlN drogato con silicio e magnesio, ciò potrebbe aprire la porta a dispositivi elettronici e ottici con prestazioni significativamente migliorate.
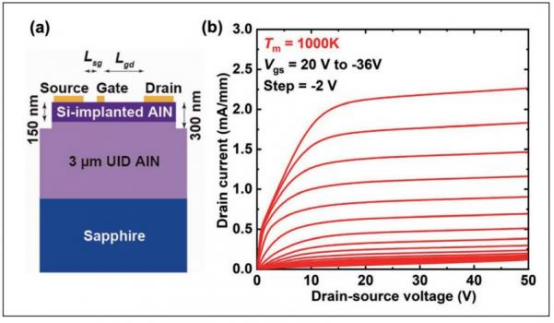
Figura 5. (a) Sezione trasversale schematica di MESFET con un canale AlN impiantato in silicio. (b) Caratteristiche di uscita CC di un MESFET AlN a 727 °C.
Proprietà elettriche dell'AlN
Per migliorare le prestazioni elettriche dei dispositivi basati su AlN, c’è molto altro da fare oltre al semplice problema dell’elevata resistività degli strati AlN di tipo n e di tipo p che sono compromessi dalle basse concentrazioni di portatori. Inoltre, è necessario affrontare il problema dell’elevata resistività di contatto, derivante dalla piccola affinità elettronica.
È particolarmente impegnativo stabilire un contatto ohmico a temperatura ambiente in AlN. La caduta di tensione è governata dall'altezza della barriera Schottky, che dipende dalla differenza tra la funzione della lavorazione del metallo e l'affinità elettronica del semiconduttore. È possibile produrre contatti ohmici abbassando l'altezza della barriera potenziale attraverso un'appropriata selezione dei materiali degli elettrodi. Le opzioni per AlN di tipo n sono titanio, alluminio, vanadio e molibdeno, mentre i contatti ohmici per AlN di tipo p possono utilizzare palladio e NiO.
Un'implicazione del drogaggio pesante nei materiali semiconduttori è una diminuzione dell'ampiezza della regione di svuotamento, che porta al tunneling attraverso potenziali barriere. Il forte drogaggio della superficie AlN più alta è molto importante per i contatti ohmici. Tuttavia, poiché la concentrazione di droganti di silicio e magnesio negli strati AlN è limitata a circa 1019 cm-3, forse a causa della formazione di difetti di compensazione, non vi è alcuna prospettiva per il tunneling delle emissioni di campo.
Per determinare la concentrazione e la mobilità dei portatori nelle strutture semiconduttrici, i ricercatori tendono a ricorrere alle misurazioni dell'effetto Hall. Poiché queste misurazioni richiedono un comportamento ohmico, alcuni studi hanno utilizzato strati di contatto GaN fortemente drogati. Ciò ha consentito la determinazione delle proprietà elettriche di AlN, sia a temperatura ambiente che a temperature elevate. Insieme ad altri, abbiamo valutato la concentrazione e la mobilità dei portatori ad alte temperature, ottenendo valori per AlN di tipo n e di tipo p a temperature superiori a 200 °C e 500 °C, rispettivamente.
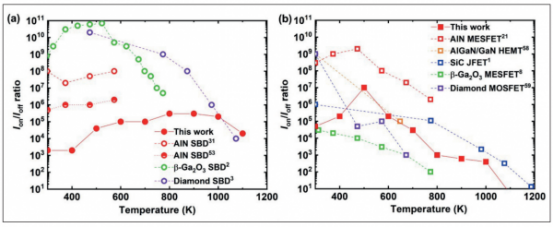
Figura 6. Un grafico di benchmarking, che confronta l'attuale rapporto on-off rispetto alla temperatura di misurazione dei dispositivi AlN con gli altri diodi a barriera Schottky all'avanguardia (a) e (b) FET.
Nell’intraprendere questo studio, abbiamo scoperto un nuovo problema associato alle misurazioni delle alte temperature. Abbiamo dovuto utilizzare una stazione sonda, poiché non disponevamo di tecnologie di incollaggio e confezionamento per temperature estreme. Abbiamo anche scoperto che le normali punte delle sonde si deteriorano alle alte temperature. Si noti che la maggior parte dei dispositivi segnalati ha una temperatura operativa massima non superiore a 500 °C, il che implica che le misurazioni delle proprietà elettriche non sono affidabili a temperature superiori a questa.
Lavorando con Dowa Electronics Materials, abbiamo valutato le caratteristiche elettriche di strati AlN spessi 3 µm su substrati di zaffiro con un sistema di sonde ad alta temperatura che offre una temperatura di misurazione massima di 900 °C in alto vuoto. A questo scopo abbiamo impiantato silicio nello strato AlN a temperatura ambiente per ottenere conduttanza di tipo n; la concentrazione era 2 × 1019 cm-3 in un profilo scatolare di 150 nm di profondità. Questi strati AlN impiantati in silicio sono stati successivamente ricotti a 1500 °C. Abbiamo quindi depositato elettrodi Ti/Al/Ti/Au per contatti ohmici, prima della sinterizzazione a 950 °C.
I nostri elettrodi si sono deteriorati a 877 °C, probabilmente a causa di una reazione tra Ti/Al e AlN. Ciò ci ha portato a cercare metalli adatti per contatti ohmici a temperature estreme. Per le temperature che abbiamo potuto considerare, abbiamo osservato una relazione corrente-tensione non lineare al di sotto di 127 °C e quasi lineare al di sopra di 227 °C. La valutazione delle proprietà elettriche tra 227 °C e 827 °C ha rivelato che la resistenza del foglio e la resistività del contatto diminuivano con l'aumentare della temperatura. Da 227 °C a 627 °C, con l'aumento della temperatura la mobilità degli elettroni diminuiva leggermente, ma la concentrazione di elettroni aumentava a causa della maggiore ionizzazione del donatore, con conseguente riduzione della resistenza del foglio alle alte temperature. Ciò ci ha portato a concludere che gli strati AlN di tipo n mostrano prestazioni eccellenti a temperature estreme.
Diodi e transistor
Abbiamo fabbricato diodi a barriera Schottky e MESFET con strati AlN impiantati in silicio su substrati di zaffiro. I nostri diodi sono in grado di funzionare a 827 °C (vedi Figura 4), superando tutti i record precedenti, mentre i nostri transistor possono funzionare fino a 727 °C (vedi Figura 5). I diodi a barriera Schottky AlN hanno una tensione di rottura di 610 V a temperatura ambiente, mentre il valore corrispondente per i MESFET AlN a 727 °C è di 176 V. Ci teniamo a sottolineare che questi dispositivi sono praticamente realizzabili, perché hanno un semplice struttura e gli strati AlN vengono coltivati su substrati di zaffiro di grandi dimensioni e a basso costo.
Per fabbricare i nostri diodi a barriera Schottky e i MESFET, abbiamo utilizzato Ni/Au per i contatti dell'anodo e del gate. Abbiamo riscontrato che il nichel è termicamente stabile e difficilmente reagisce con AlN, anche a 827 °C. Inoltre, in termini di caratteristiche elettriche, abbiamo riscontrato poca differenza tra Ni/Au e Pt/Au. Per il diodo a barriera Schottky, la corrente di disattivazione è piccola, anche a 827 °C, a causa della bassa concentrazione intrinseca di portatori e dell'interfaccia Ni/AlN termicamente stabile. Tuttavia, la corrente di drain fuori stato del MESFET AlN è elevata a 727 °C, a causa della perdita attraverso gli strati AlN non drogati inferiori e dell'elevata concentrazione di difetti. A differenza della corrente nei dispositivi al silicio, che cade a temperature elevate a causa della diffusione dei fononi, abbiamo scoperto che la corrente diretta dei diodi a barriera Schottky AlN e dei MESFET continua ad aumentare con la temperatura fino a 827 °C. Attribuiamo questo al fatto che la corrente nei dispositivi AlN a temperature estreme è dominata dall'aumento della concentrazione di elettroni e dalla riduzione della resistività di contatto, con la riduzione della mobilità degli elettroni che gioca un ruolo secondario.
Il nostro sviluppo di dispositivi AlN sta aprendo un nuovo modo per realizzare dispositivi a semiconduttore in grado di funzionare a temperature estreme. Sebbene esista un compromesso tra il rapporto on-off e la temperatura dei diodi a barriera Schottky e dei FET (vedere Figura 6), i dispositivi AlN hanno un grande potenziale di miglioramento. Ad esempio, dovrebbe essere possibile aumentare il rapporto on/off a temperature estreme attraverso una combinazione di crescita omoepitassiale e l'introduzione di una struttura JFET. Ulteriori miglioramenti potrebbero derivare dall'introduzione di contatti ohmici resistenti al calore, anziché Ti/Al/Ti/Au, una mossa che aumenterebbe la temperatura operativa a oltre 877 °C.
Per la maggior parte delle applicazioni a temperature estreme, i circuiti integrati devono funzionare in modo affidabile per lunghi periodi. Tali circuiti sono fabbricati con tecnologia complementare, con canali n e p. Presso l'Università di Kyoto, gli ingegneri hanno sviluppato una porta logica JFET complementare al SiC che funziona a 350 °C. Speriamo di portare il nostro lavoro in una direzione simile, producendo JFET complementari con canali AlN omoepitassiali in grado di operare in ambienti estremi.
DI HIRONORI OKUMURA DELL'UNIVERSITÀ DI TSUKUBA
da https://compoundsemiconductor.net/article/118570/Extreme-temperature_devices_using_AlN
Perché hai bisogno dei nostri servizi, sai che stai ricevendo professionisti altamente qualificati che hanno la competenza e l'esperienza per assicurarti che il tuo progetto sia svolto correttamente e funzioni.
se desideri una consulenza gratuita, inizia bg compilando il modulo:
Ricevi informazioni sulla vendita, notizie e aggiornamenti nella tua casella di posta.
 闽ICP备19012761号-1
闽ICP备19012761号-1



